基于SEM平台的纳米探针系统,具有低电压超高分辨率的SEM图像,操作者通过控制摇杆可以任意移动探针位置,在移动的过程中SEM图像可以实时且准确地呈现出针尖所处的位置。针尖的定位由精密的压电陶瓷控制,8根探针和样品台分别可以在X、Y和Z三个方向上移动。
同时SEM base nanoprobe集成
EBACEBICEBRICH等多功能失效定位能力,广泛地用于失效分析实验室,以帮助提高产品良率、质量和可靠性。
技术优势
1.可实现低至100V的高分辨成像,同时可避免电子束对器件造成的损伤
2.八探针配置,可提供多至八根针的电性表征
3.电子束吸收电流(EBAC)功能,用于定位open/bridge缺陷
4.施加电压的EBAC功能(EBIRCH/DI-EBAC),用于定位低阻/漏电缺陷
5.温度可控样品台,-50℃~150℃复现高温/低温故障
6.高速脉冲测试Pulsing-用于诊断栅极缺陷的脉冲IV测量
7.CV-用于MOSCAP/MOSFET的电容测试
功能介绍
01
电性表征
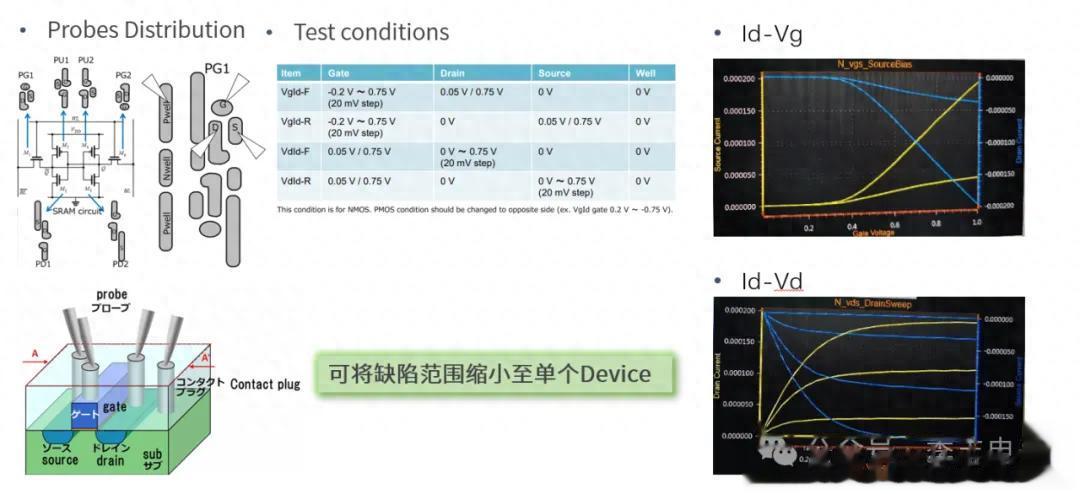
02
EBAC
当电子显微镜中的电子束(E-beam)照射在样品上并扫描至某定点时,若此处为金属导线且有通过纳米探针导通,则电子会被金属导线吸收,再经由纳米探针(Nano-Probe)导出至放大器(Amp),进而得到该位置的吸收电流,经由信号处理可以形成电流图像,我们将其称为EBAC(Electron Beam Absorbed Current)图像。
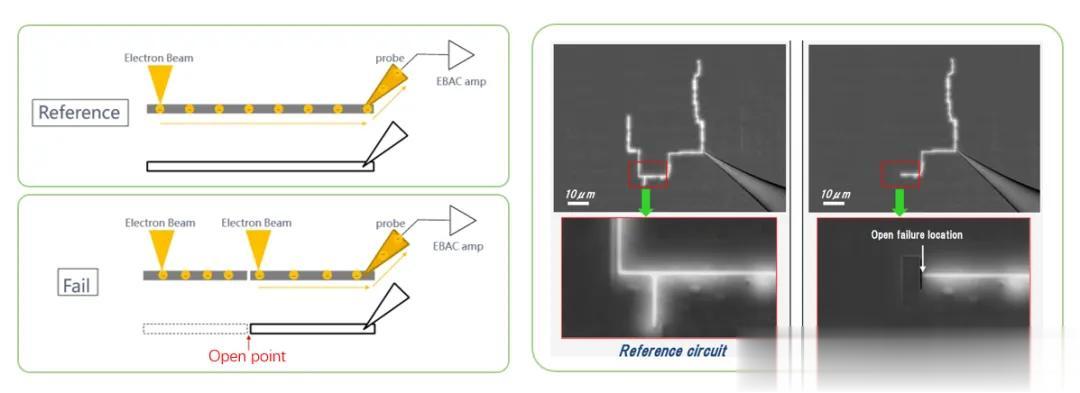
03
EBIRCH
EBIRCH的原理与激光束电阻异常侦测(OBIRCH) 相同,差异只是在OBIRCH所用的激发源为laser,受限于laser波长的关系,其空间分辨率约为微米(µm)等级;而EBIRCH的激发源为电子显微镜的电子束,其波长远小于雷射,因此可以将空间分辨率提升至纳米(nm)等级,进而可更精准地定位出缺陷位置,大幅增加后续进行物性故障分析的缺陷呈现能力与TEM分析的成功率。
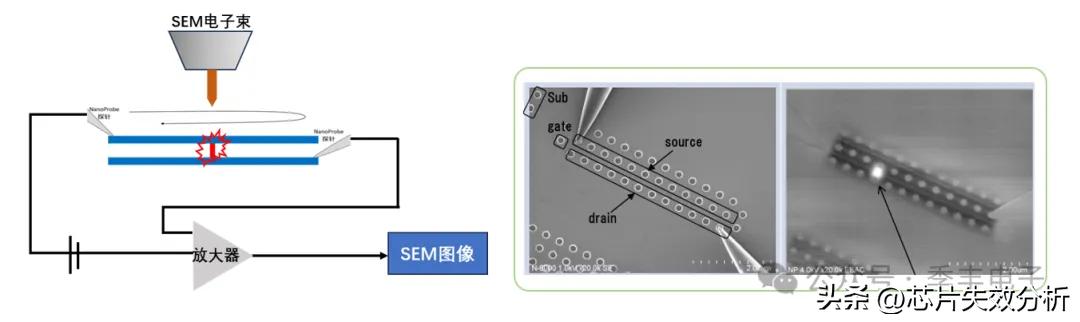
04
CV
CV是针对电容(C)与电压(V)的量测。通常,CV常用于MOSCAP和MOSFET的电容测试。所测得的C值通常会非常小,例如pF或更小。
电容是由AC信号检测直流电压作用于样品时器件的结果计算得出。
AC频率范围:10kHz~1MHz
电容: =/
其中=area, = s& =

05
Pulsing
高速脉冲系统使用脉冲发生器配合高速示波器,动态激励样品中的电路或者晶体管,记录其输出信号,可观察到纳秒级的器件响应。通过参考信号进行比较,我们可以看到晶体管的缓慢响应或失效电路的延迟响应,从而可定位出栅极高阻缺陷。
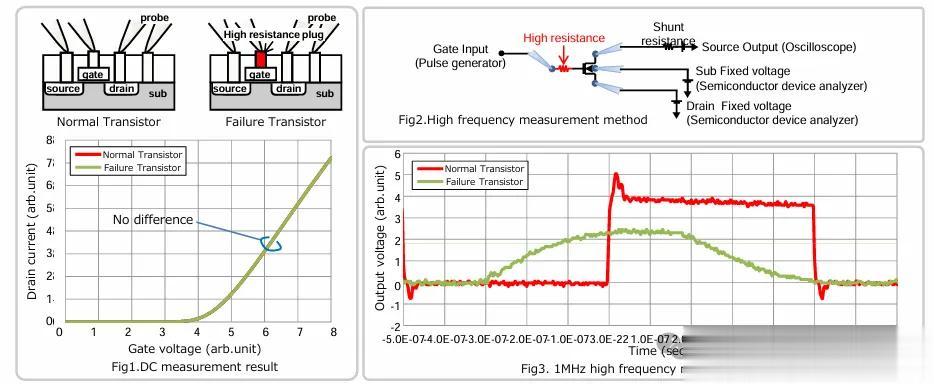
应用场景
01
失效定位与故障分析
电性定位:通过IV特性、CV特性及脉冲测试,识别晶体管或互连的电性异常(如短路、开路、漏电);
缺陷成像定位:利用EBAC(电子束吸收电流)、EBIC(电子束感应电流)、EBRICH(电子束感生阻抗变化)等技术,对晶格缺陷、pn结失效等进行可视化定位。
02
器件与电路性能表征
存储单元评估:测量SRAM(静态随机存储器)单元的静态噪声容限(SNM)及核心晶体管IV曲线,评估其读写稳定性与性能。
基础参数测量:在纳米尺度直接测量电阻R、电容C及极微弱的漏电流,用于互连线、接触孔、栅极结构的性能评估。
03
综合分析与前沿研究
环境可靠性测试:在-50℃至+150℃的高低温环境下进行表征,研究器件性能随温度变化及可靠性。
反向工程与对标分析:通过逐层、逐点的电学测量,辅助进行电路提取和工艺技术解析。
可靠性测试:支持可靠性相关应力测试与监控。
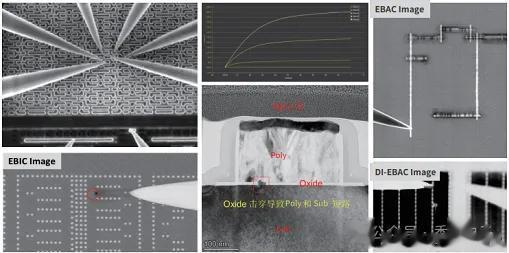
Nanoprobe在半导体
缺陷分析流程中的作用
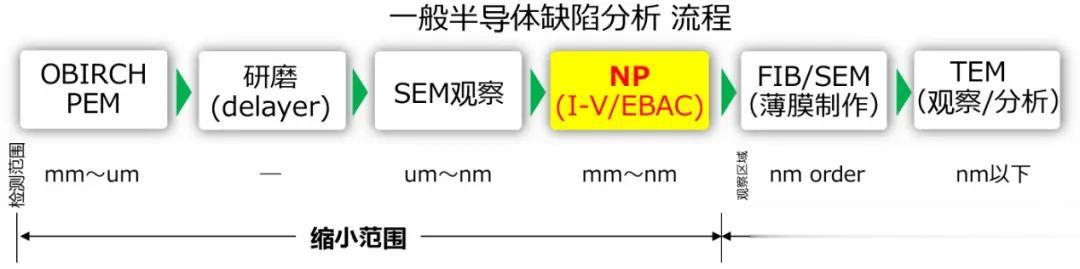

来源:季丰电子