EMMI的原理与作用
微光显微镜(EMMI)是一种被动检测技术,其核心原理是检测芯片在通电工作时,因特定物理效应产生的微弱光子发射。芯片内部的半导体结构在正常工作时,电子与空穴的复合过程会释放能量,但多数以热能形式耗散,仅极少量转化为光子。当芯片出现失效时,异常电学行为会显著改变光子释放过程。例如漏电失效时,若芯片存在氧化层针孔、金属连线缺陷等形成局部漏电通道,电子与空穴的复合概率大幅提升,释放的光子强度显著增加;PN结击穿时,大量载流子高速碰撞产生雪崩光子,形成明显发光点;晶体管热载流子效应异常时也会出现局部发光增强。EMMI系统通过高灵敏度CCD相机、长焦距显微镜头和窄带滤波片的组合,将芯片表面的微弱光子信号放大并生成发光强度分布图,图像中亮度较高区域即为失效概率最高区域。
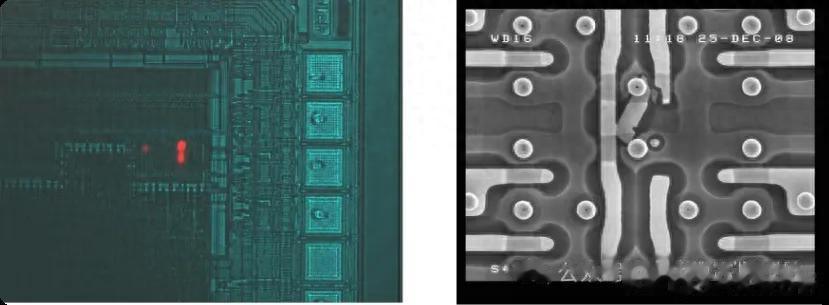
EMMI在实际失效分析中主要适用于定位伴随光子释放的电学失效,包括漏电点定位如芯片输入引脚与衬底间的氧化层漏电、金属连线间的微短路漏电、CMOS电路中的闩锁效应漏电等;PN结相关失效如二极管反向击穿、三极管发射结或集电结损坏;以及封装级失效如引线键合点的接触不良、裸片与基板间的微间隙漏电。对于器件结漏电、热载子、氧化层漏电、异物污染有源区、机械损伤等情况,EMMI具有较高灵敏度。
OBIRCH的原理与作用
光束诱导电阻变化测试(OBIRCH)是一种主动探测技术,其核心逻辑是通过聚焦激光束对芯片表面进行扫描,激光能量使芯片内部材料产生局部温升进而导致电阻变化,若存在失效缺陷,缺陷区域的电阻变化规律会与正常区域产生差异,通过检测这种差异即可定位失效点。其原理可拆解为激光加热、电阻变化、差异检测三个步骤。激光束经聚焦形成直径仅1-5微米的激光探针逐点扫描芯片表面,激光能量被芯片内部材料吸收导致局部温度升高。根据电阻温度系数特性,半导体材料电阻随温度升高而减小,金属材料电阻随温度升高而增大。在激光扫描同时向芯片施加恒定电压或恒定电流,通过高精度电表实时监测变化。若芯片存在开路缺陷,断裂处无电流通过,激光加热时无电阻变化信号形成信号空白区;微短路缺陷处电流密度更高,激光加热后电阻变化幅度更大形成信号峰值区;漏电通道电阻本身低于正常区域,激光加热后电阻变化幅度与正常区域差异显著形成信号异常区。通过将激光扫描位置与电阻变化信号同步映射,即可生成信号分布图,图中信号异常区域即为失效点。

OBIRCH的优势在于不受光子释放限制,可定位EMMI无法检测的失效模式,核心应用包括开路缺陷定位如金属互连线断裂、引线键合点虚焊、通孔堵塞或断裂;微短路缺陷定位如相邻金属连线间微小桥接、晶体管源漏极间寄生短路;低电流漏电定位部分芯片漏电电流极小EMMI无法捕捉时,OBIRCH可通过电阻变化差异定位漏电通道;以及非发光失效定位如金属连线电阻异常增大、半导体材料电阻率不均匀等。针对金属化系统层面的金属线路桥接、空洞、材料结构异常阻值、漏电路径等,OBIRCH具有较好检测效果。
EMMI与OBIRCH的核心区别
EMMI与OBIRCH在核心原理、检测前提、适用失效模式等方面存在本质差异。EMMI基于光子发射捕捉失效区域释放的微弱光子,检测前提是失效区域必须伴随光子释放,主要适用于漏电、PN结击穿、热载流子效应等发光型失效。OBIRCH基于热电阻效应检测激光加热引发的电阻变化差异,无需光子释放,仅需失效区域与正常区域存在电阻差异,适用于开路、微短路、低电流漏电、电阻异常等非发光型失效。空间分辨率方面,EMMI取决于光学系统通常为1-3微米,OBIRCH取决于激光聚焦精度通常为0.5-2微米。检测深度方面,EMMI光子易被硅衬底吸收仅能检测芯片表面下5-10微米的失效,OBIRCH激光可穿透硅衬底检测表面下20-50微米的失效。样品准备方面,两者均需去除芯片封装暴露裸片,OBIRCH部分场景还需对芯片表面减薄以增强激光穿透性。

协同应用与实际案例
在实际失效分析流程中,EMMI和OBIRCH高度互补。初步定位时可先用EMMI快速扫描,如果发现明显发光点则问题可能主要是漏电。如果EMMI没有发现或发现点无法解释故障现象,则可使用OBIRCH扫描寻找电阻性异常。有时复杂缺陷如ESD损伤可能同时包含漏电和电阻变化,两种技术都能在相近位置给出信号相互验证,提高定位准确性。
实际应用案例方面,半导体芯片生产或使用过程中发现漏电短路时,通过外观检查未发现异常,经热点定位分析发现异常热点,用聚焦离子束对热点切割后可在扫描电镜下观察到截面缺陷。在器件分析中,EMMI热点可观察到浅槽隔离角击穿,字线多处断裂也可在EMMI热点发现。对于电路静电释放故障分析,可在电路特定位置发现ESD损坏。