IT之家2月3日消息,科技媒体MacObserver昨日(2月2日)发布博文,报道称针对近期关于“苹果将在iPhone中采用英特尔芯片”的传闻,多位半导体行业专家表示该可能性几乎为零。
此次传闻源于DigiTimes的一份报道。该报道指出,苹果正评估将英特尔18AP工艺用于计划于2027年发布的低端M系列芯片,甚至可能在2028年用于非Pro版iPhone的芯片生产。
此外,广发证券(GFSecurities)分析师蒲得宇JeffPu补充称,苹果计划于2028年推出的定制ASIC芯片也将采用英特尔的EMIB封装技术。
还有消息称英特尔已与苹果签署保密协议(NDA),并交付了18AP设计套件以供测试,该节点也是英特尔首个支持FoverosDirect3D混合键合技术的工艺,允许芯片进行垂直堆叠。
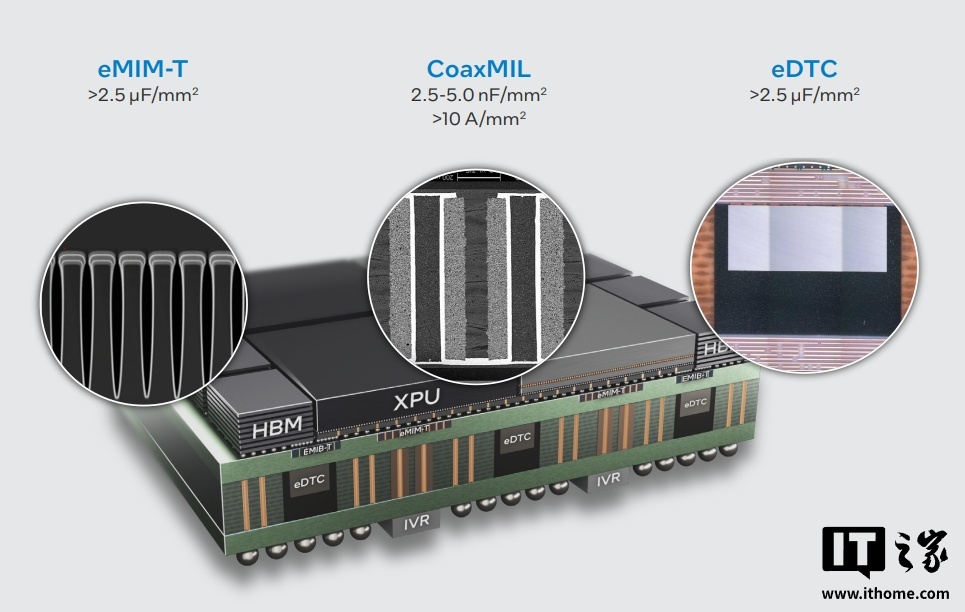
不过SemiWiki论坛专家指出核心技术障碍:散热。英特尔在18A和14A节点上全面采用了被称为PowerVia的背面供电技术(BSPD)。

相比之下,台积电则采取了更为灵活的策略,提供含BSPD和不含BSPD的多种节点供设计者选择。专家分析,虽然BSPD能优化供电效率并提升性能,但其结构特性会导致芯片运行温度升高。
行业专家IanD指出在保持相同芯片核心温度(Hotspots)的前提下,采用BSPD技术的芯片需要散热器温度降低约20°C才能维持热平衡。IT之家附上相关截图如下:

其主要原因是BSPD结构导致垂直导热性能变差,且由于缺乏厚硅基板,横向导热能力也大幅削弱。对于依赖空气冷却(AirCooling)且机身空间极度受限的iPhone而言,这种热积聚是致命的。
综上所述,英特尔的先进工艺虽然在性能指标上具有竞争力,但其热力学特性并不适合智能手机。业内普遍认为,英特尔或许有机会争取到散热条件相对宽松的低端M系列(Mac)芯片订单,但在解决严重的积热问题之前,iPhone处理器的大门对其依然紧闭。







